KRi 射频离子源 RFICP 220 IBE 离子束刻蚀阅读数: 5738

KRi 射频离子源典型应用: 12英寸, 8英寸 IBE 离子束刻蚀系统
上海伯东美国 KRi 考夫曼公司大口径射频离子源 RFICP 380, RFICP 220 成功应用于 12英寸和 8英寸 IBE 离子束蚀刻机, 实现 300mm 和 200 mm 硅片蚀刻, 刻蚀 均匀性(1 σ)达到< 1%. KRi 离子源可以用来刻蚀任何固体材料, 包括金属, 合金, 氧化物, 化合物, 混合材料, 半导体, 绝缘体, 超导体等.
离子束刻蚀属于干法刻蚀, 其核心部件为离子源. 作为蚀刻机的核心部件, KRi 射频离子源提供大尺寸, 高能量, 低浓度的宽束离子束, 接受客户定制, 单次工艺时间更长, 满足各种材料刻蚀需求!

客户案例: 12英寸 IBE 离子束蚀刻机安装 KRi 射频离子源
KRi 离子源工作过程: 气体通入离子源的放电室中, 电离产生均匀的等离子体, IBE系统由离子源的栅极将正离子引出并加速, 然后由中和器进行中和. 利用引出的带有一定动能的离子束流撞击样品表面, 通过物理溅射将材料除去, 进而获得刻蚀图形. 这一过程属于纯物理过程, 一般运行在较高的真空度下.


由于等离子体的产生远离晶圆空间, 起辉不受非挥发性副产物的影响.
这种物理方案, 栅网拉出的离子束的能量和密度可以独立控制, 提升了工艺可控性
通过载片台的角度调整, 实现离子束倾斜入射, 可用于特殊图案的刻蚀, 也适用于侧壁清洗等工艺.
蚀刻多层时不需要化学优化, 一般工艺通氩气, 也可通活性气体.
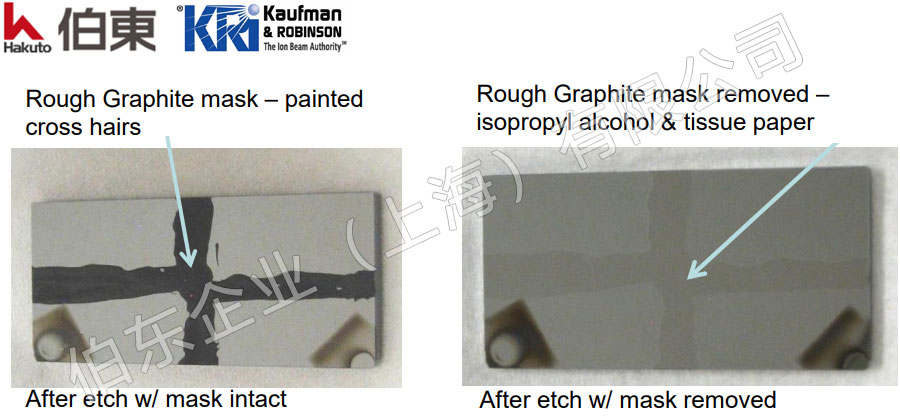
KRi 射频离子源 RFICP 系列技术参数:
|
型号 |
|||||
|
Discharge 阳极 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
|
离子束流 |
>100 mA |
>350 mA |
>600 mA |
>800 mA |
>1500 mA |
|
离子动能 |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
|
栅极直径 |
4 cm Φ |
10 cm Φ |
14 cm Φ |
20 cm Φ |
30 cm Φ |
|
离子束 |
聚焦, 平行, 散射 |
|
|||
|
流量 |
3-10 sccm |
5-30 sccm |
5-30 sccm |
10-40 sccm |
15-50 sccm |
|
通气 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
||||
|
典型压力 |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
|
长度 |
12.7 cm |
23.5 cm |
24.6 cm |
30 cm |
39 cm |
|
直径 |
13.5 cm |
19.1 cm |
24.6 cm |
41 cm |
59 cm |
|
中和器 |
LFN 2000 |
||||
上海伯东同时提供IBE 离子蚀刻系统所需的涡轮分子泵, 真空规, 高真空插板阀等产品, 协助客户生产研发高质量的蚀刻系统.
1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源, 霍尔离子源和射频离子源. 美国考夫曼离子源历经 40 年改良及发展已取得多项成果. 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域, 上海伯东是美国 KRi 考夫曼离子源中国总代理.
若您需要进一步的了解 KRi 射频离子源, 请参考以下联络方式
上海伯东: 叶小姐 台湾伯东: 王小姐
M: +86 1391-883-7267 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 1391-883-7267 M: +886-939-653-958
上海伯东版权所有, 翻拷必究!

 上海
上海